
Рисунок 1 . ВАХ многокомпонентных гетероструктур с содержанием атомов In X = 0?0,35 в квантово-размерных ямах в диапазоне а - j=0,1?15 А/см 2 , б - j=15?500 А/см 2
Рабинович О.И., Наими Е.К., Сушков В.П., МИСиС; Никифоров С.Г., ATV Outdoor Systems; г. Москва
За последнее десятилетие произошёл прорыв в исследованиях и производстве нитридных многокомпонентных гетероструктур (МКГ), а также приборов на их основе. Обширный диапазон изменения ширины запрещённой зоны (1,95-6,3 эВ), сильные связи взаимодействия и высокая теплопроводность соединений III-й группы, таких как GaN, InN, AlN и их твёрдых растворов In х Ga 1-х N и Al y Ga 1- y N, делают их особенно интересными для применения в оптоэлектронных приборах, высокомощной и высокочастотной электронике [1-5]. Яркими представителями оптоэлектронных полупроводниковых приборов являются излучающие диоды (ИД).
Количество областей применения ИД неуклонно расширяется. Сегодня методы производства полупроводниковых материалов, прогресс в создании ИД и появление этих приборов на основе МКГ AlInGaN, позволили решить проблемы увеличения светового выхода, ограниченность диапазона цветов и, главное, создания ИД белого цвета свечения, что ранее препятствовало применению ИД в освещении.
Широкое применение ИД на основе МКГ AlGaInN обнаруживает и проблемы, требующие решения: увеличение эффективности и срока эксплуатации ИД, изучение и прогнозирование деградации рабочих характеристик ИД при влиянии различных воздействий.
Необходимо иметь способ получения оптимальных параметров, причём экономя материальные затраты. Для подобных сложных объектов расчёты основных зависимостей, определяющих качество ИД, таких как вольт-амперные характеристики (ВАХ), внутренний квантовый выход излучения и его зависимость от плотности тока, требуют использования численных методов компьютерного моделирования [6], учитывающих всё многообразие конструктивных, физических и технологических параметров МКГ. Подобный подход был успешно продемонстрирован для AlGaInN лазеров в работах С. Накамуры (Sh. Nakamura) и A. Томчука (A. Tomczyk). Использование компьютерного моделирования представляется актуальным, так как позволяет не только уточнить теоретические характеристики AlGaInN МКГ, но и значительно сэкономить материальные средства при отработке технологии их получения.
Исследовались МКГ AlGaInN типа p+GaN/p+Al0,2Ga0,8N/4·(n-InXGa1-XN-n-GaN)/n+GaN с различным содержанием атомов In (Х) в квантово-размерных ямах (КЯ). Введение в конструкцию МКГ p-Al0,2Ga0,8N-эмиттера обусловлено необходимостью исключить инжекцию электронов из активной области, что особенно важно при моделировании приборов с малым содержанием атомов In. В частности проводилось моделирование МКГ для ИД синего и зелёного цветов свечения с различным по величине и однородным содержанием атомов In (X) в InХGa1-ХN-КЯ в плоскости, параллельной плоскости p-n-перехода, для определения влияния величины Х на электрические и оптические характеристики ИД. Файлы, описывающие приборы, содержали следующие параметры КЯ и барьеров в активной области:
ВАХ МКГ с различным содержанием атомов In в КЯ представлены на рис. 1 . При достаточно больших значениях плотности тока, наблюдающиеся отклонения ВАХ МКГ с КЯ от ВАХ с Х = 0, отражаемые зависимостями значений коэффициента неидеальности (n) от J и Х ( рис. 2 ), в основном обусловлены особенностями физических процессов, происходящих в активной квантово-размерной области.

Рисунок 1 . ВАХ многокомпонентных гетероструктур с содержанием атомов
In X = 0?0,35 в квантово-размерных ямах в диапазоне а - j=0,1?15 А/см 2
, б - j=15?500 А/см 2
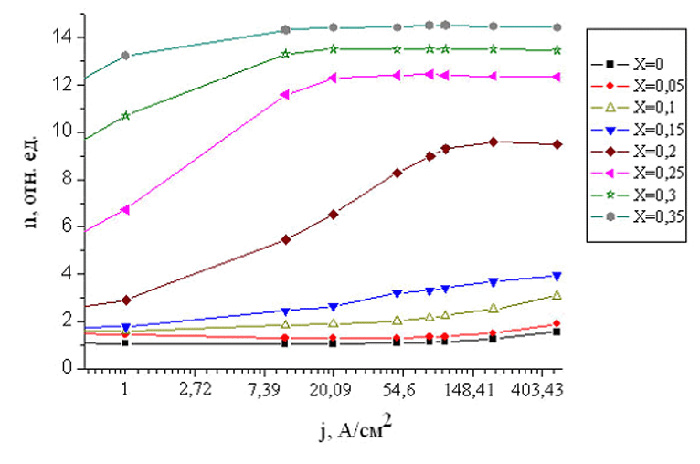
Рисунок. 2. Зависимости величины коэффициента неидеальности (n) ВАХ от
плотности тока: при различном содержании атомов In в КЯ
Расчёты ВАХ МКГ показали, что изменение n с плотностью тока зависит не только от содержания атомов In в КЯ, но и от степени легирования барьеров между КЯ.
Анализ поведения ВАХ и зависимость коэффициента неидеальности (n) от плотности тока на МКГ с различным содержанием атомов In ( рис. 2 ) выявляет: в отсутствии КЯ (Х = 0) ВАХ имеет общеизвестный вид; в области малых плотностей тока, вплоть до J = 0,1 А/см 2 , n›1, что связано с существенным влиянием на значение тока процессов рекомбинации электронов и дырок в области объёмного заряда; затем всё более начинает преобладать ток надбарьерной инжекции носителей заряда, при этом n>1 при малом уровне инжекции (J = 1?20 А/см 2 ) и n>2 при увеличении уровня инжекции (J = 20?500 А/см 2 ); наличие КЯ начинает сказываться на виде ВАХ уже при значениях Х=0,05?0,1, особенно в диапазоне Х = 0,1?0,35; при Х›0,1 величина n постепенно растёт во всём диапазоне J = 0,1?500 А/см 2 , достигая значений n›2 и даже n 2 при Х›0,15.
При малых значениях Х = 0,05?0,1 с ростом плотности тока концентрации электронов и дырок в КЯ увеличиваются, а неравномерность их распределений по КЯ уменьшается, при этом значение напряжённости тормозящего электрического поля в квантово-размерной области уменьшается, достигая нуля при Х = 0,1 и J = 100 А/см 2 . При одном и том же значении J и при Х›0,1 в активной области постепенно начинает возникать ускоряющее электрическое поле, достигающее при Х = 0,2 и J = 100 А/см 2 значения 3·10 5 В/см, а при Х = 0,3 и J = 100 А/см 2 значения 1,5·10 6 В/см ( рис. 3 ).
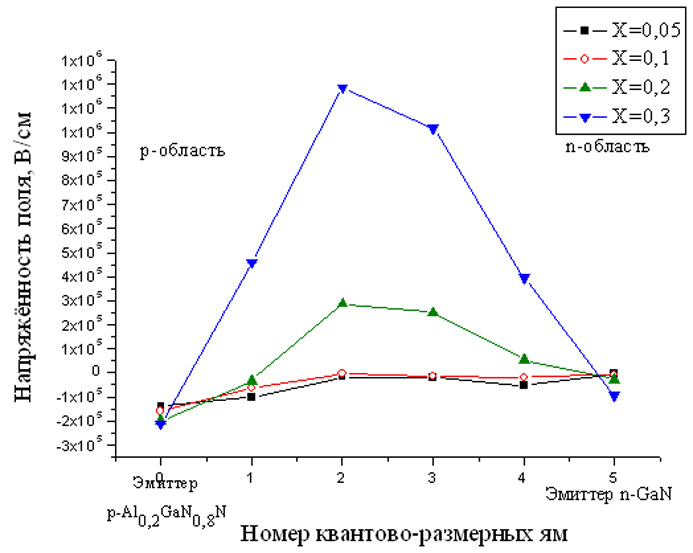
Рисунок 3. Зависимость напряжённости поля от содержания атомов In и её
распределение по КЯ при J = 100 А/см2
Кристалл ИД, имеющий площадь p-n-перехода S МКГ , может быть рассмотрен как совокупность параллельно соединенных квантово-размерных областей с различным содержанием атомов In (Х) в МКГ и имеющих площади p-n-перехода S(X) - “нано-ИД”.
В качестве примера ( рис. 4, 5 ) представлены результаты моделирования ИД синего цвета свечения при Т = 300 К. Зонная диаграмма “нано-ИД” с четырьмя КЯ (X = 0,2) при напряжении 3,842 В и Т = 300 К показана на рис. 4 .
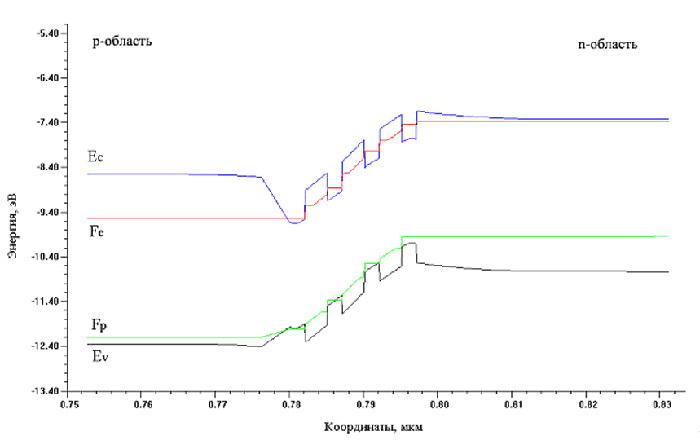
Рисунок 4. Зонная диаграмма ИД синего цвета свечения с четырьмя КЯ,
(Х=0,2; J=100 A/мc 2 ; T=300 K)
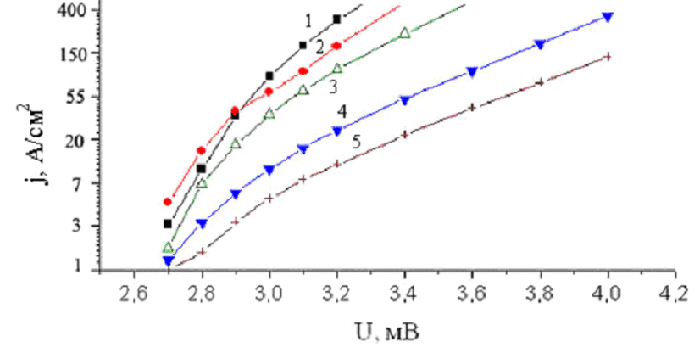
Рисунок 5. Зависимость плотности тока от напряжения 1-Х=0,15; 2-Х=0,17;
3-Х=0,2; 4-X=0,22; 5-X=0,25; T=300 K
Зависимости плотности тока от напряжения (ВАХ) для “нано-ИД” с различным содержанием In представлены на рис. 5 . Видно, что при одинаковом напряжении плотность тока зависит от X.
На рис. 6-7 видно хорошее согласие результатов моделирования и экспериментов при том, что результаты моделирования получены без каких-либо дополнительных (сверх базовых физических моделей) приближений и аппроксимаций. Для сравнения представлены экспериментальные ВАХ, измеренные на ИД компании Cree Inc., типа C460MB290E1000.

Рисунок 6. ВАХ ИД синего цвета свечения 1 - результаты моделирования 2
- экспериментальные данные, Т=300 К

Рисунок 7 . Спектры мощности излучения ИД синего цвета свечения 1 -
результаты моделирования, 2 - экспериментальные данные, Т=300 К.
По результатам моделирования видно, что через области с пониженным относительно среднего значения содержания атомов In Х=0,2 протекают значительно большие токи, чем через области с повышенным содержанием атомов In ( рис. 5 ). Следовательно, с одной стороны области, через которые протекают большие токи, “выгорают”, т.е. их излучательная способность уменьшается; с другой стороны возможно перераспределение содержания атомов In в сторону увеличения количества областей с повышенным содержанием атомов In. Это объясняет тенденцию смещения спектров излучения в длинноволновую область при длительной наработке ИД (рис. 7 ).
Выводы:
Литература:
Раздел статей о
светодиодах и свете